要想造个
芯片, 首先, 你得画出来一个长这样的玩意儿给Foundry (外包的晶圆制造公司)
P�V�I�Oe}N 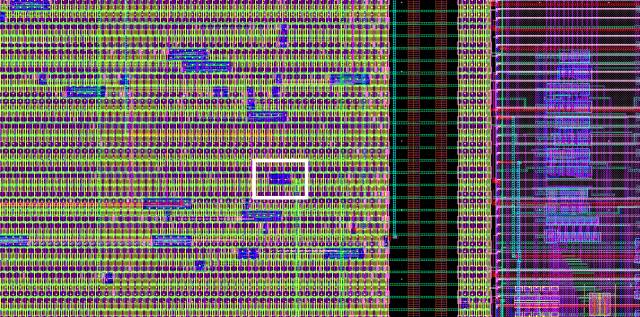 }bb,�Iib�
}bb,�Iib� 把它放大...
JO�J�.79CT  &t=�:xVn-M
&t=�:xVn-M 我们终于看到一个门
电路啦! 这是一个NAND Gate(与非门), 大概是这样:
w:5?�of�C�  ON�,[!�pc�
ON�,[!�pc� A, B 是输入, Y是输出.
Pk;\^DR�C� 其中蓝色的是金属1层, 绿色是金属2层, 紫色是金属3层, 粉色是金属4层...
M�g��XZN{ 那
晶体管(更正, 题主的"晶体管" 自199X年以后已经主要是 MOSFET, 即场效应管了 ) 呢?
E_
�w�VAz3 仔细看图, 看到里面那些白色的点吗? 那是衬底, 还有一些绿色的边框? 那些是Active Layer (也即掺杂层.)
y
b��hF�Dx 然后Foundry是怎么做的呢? 大体上分为以下几步:
�2:38CdkYp 首先搞到一块圆圆的硅晶圆, (就是一大块晶体硅, 打磨的很光滑, 一般是圆的)
/6�'�)B !& 图片按照生产步骤排列. 但是步骤总结单独写出. ui%#f�1Iq� 1、湿洗(用各种试剂保持硅晶圆表面没有杂质)
$��
�V�T) 2、光刻 (用紫外线透过蒙版照射硅晶圆, 被照到的地方就会容易被洗掉, 没被照到的地方就保持原样. 于是就可以在硅晶圆上面刻出想要的图案. 注意, 此时还没有加入杂质, 依然是一个硅晶圆. )
]l��,D,d81 3、 离子注入(在硅晶圆不同的位置加入不同的杂质, 不同杂质根据浓度/位置的不同就组成了场效应管.)
�EtcT:k?y� 4、刻蚀
��1SEx�l�U 4.1、干蚀刻 (之前用光刻出来的形状有许多其实不是我们需要的,而是为了离子注入而蚀刻的. 现在就要用等离子体把他们洗掉, 或者是一些第一步光刻先不需要刻出来的结构, 这一步进行蚀刻).
e$�[O J<t� 4.2、湿蚀刻(进一步洗掉, 但是用的是试剂, 所以叫湿蚀刻).--- 以上步骤完成后, 场效应管就已经被做出来啦~ 但是以上步骤一般都不止做一次, 很可能需要反反复复的做, 以达到要求. ---
$e�\s8$EO� 5、等离子冲洗(用较弱的等离子束轰击整个芯片)
g88k@��<Y� 6、热处理, 其中又分为:
$|�~�<6A{y 6.1、快速热退火 (就是瞬间把整个片子通过大功率灯啥的照到1200摄氏度以上, 然后慢慢地冷却下来, 为了使得注入的离子能更好的被启动以及热氧化)
\D@j`o���� 6.2、退火
i�f*�V-$[I 6.3、热氧化 (制造出二氧化硅, 也即场效应管的栅极(gate) )
t�\�M6 d6� 7、化学气相淀积(CVD), 进一步精细处理表面的各种物质
&W45��.��2 8、物理气相淀积 (PVD),类似, 而且可以给敏感部件加coating
�\��lb�H
� 9、分子束外延 (MBE) 如果需要长单晶的话就需要这个..
Ok!P�~�2J� 10、电镀处理
~�su>RolaX 11、化学/机械 表面处理然后芯片就差不多了, 接下来还要:
%p�� 6�Ms� 12、晶圆测试
%3`*)cp�@ 13、晶圆打磨就可以出厂
封装了.
.Rro�O_H
� 下面我们来一步步看:
f)�Q�ln[�/  o<nM�-"yWb
o<nM�-"yWb 1、上面是氧化层, 下面是衬底(硅) -- 湿洗
:Q�a*-)rs�  �?/.�])'&b
�?/.�])'&b 2、一般来说, 先对整个衬底注入少量(10^10 ~ 10^13 / cm^3) 的P型物质(最外层少一个
电子), 作为衬底 -- 离子注入
*y4DK6OFe  BZ?w}%-�MO
BZ?w}%-�MO 3、先加入Photo-resist, 保护住不想被蚀刻的地方 -- 光刻
��QNb�Z)� 4、上掩膜! (就是那个标注Cr的地方. 中间空的表示没有遮盖, 黑的表示遮住了.) -- 光刻
��V D�#q�\ 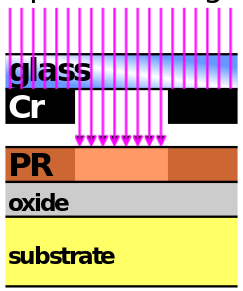 7J);{ &x9h
7J);{ &x9h 5、紫外线照上去... 下面被照得那一块就被反应了 -- 光刻
z4YD�ngf=4  mnA_$W3�~I
mnA_$W3�~I 6、撤去掩膜. -- 光刻
v?He�]��e'  F$UL.`X
_/
F$UL.`X
_/ 7、把暴露出来的氧化层洗掉, 露出硅层(就可以注入离子了) -- 光刻
OLx�;j+�p
 1�K/HVj+'.
1�K/HVj+'. 8、把保护层撤去. 这样就得到了一个准备注入的硅片. 这一步会反复在硅片上进行(几十次甚至上百次). -- 光刻
�f��&vMv�.  �L(�3&,!@�
�L(�3&,!@� 9、然后光刻完毕后, 往里面狠狠地插入一块少量(10^14 ~ 10^16 /cm^3) 注入的N型物质就做成了一个N-well (N-井) -- 离子注入
!j�$cBf�4� 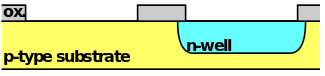 a4s�'t%
P�
a4s�'t%
P� 10、用干蚀刻把需要P-well的地方也蚀刻出来. 也可以再次使用光刻刻出来. -- 干蚀刻
c�xR.�:LD} 11、上图将P-型半导体上部再次氧化出一层薄薄的二氧化硅. -- 热处理
�fM.�#FT?? 12、用分子束外延处理长出的一层多晶硅, 该层可导电 -- 分子束外延
/`m�*��PgJ 13、进一步的蚀刻, 做出精细的结构. (在退火以及部分CVD) -- 重复3-8光刻 + 湿蚀刻13 进一步的蚀刻, 做出精细的结构. (在退火以及部分CVD) -- 重复3-8光刻 + 湿蚀刻
X5o�*8Bg4M 14、再次狠狠地插入大量(10^18 ~ 10^20 / cm^3) 注入的P/N型物质, 此时注意MOSFET已经基本成型. -- 离子注入
"mn��?���* 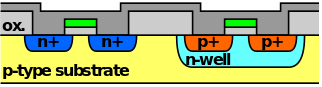 {iyJ�H��Y
{iyJ�H��Y 15、用气相积淀 形成的氮化物层 -- 化学气相积淀
&k'<�xW?�x 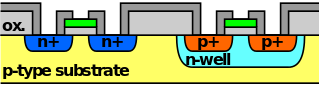 k~�)C�J6}�
k~�)C�J6}� 16、将氮化物蚀刻出沟道 -- 光刻 + 湿蚀刻
"nz\Y�Q�dg 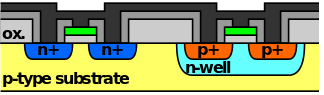 ^li3*�#eT�
^li3*�#eT� 17、物理气相积淀长出 金属层 -- 物理气相积淀
Y2VfJ}%�Q� 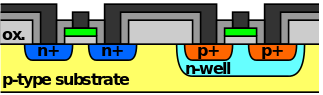 .5\@G b.8�
.5\@G b.8� 18、将多余金属层蚀刻. 光刻 + 湿蚀刻重复 17-18 长出每个金属层哦对了... 最开始那个芯片, 大小大约是1.5mm x 0.8mm.
{J"]tx9
] 下面细说一下光刻.。按照常理小于头发丝直径的操作会很困难, 所以光刻(比如说100nm)是怎么做的呢?
-�7!L]BcZ. 比如说我们要做一个100nm的门电路(90nm technology), 那么实际上是这样的:
d./R;Z- I{ 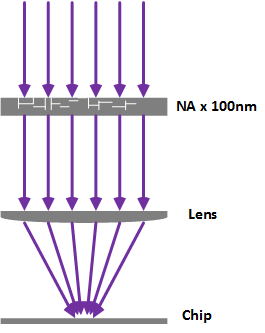 Fx!D:.)�/G
Fx!D:.)�/G 这层掩膜是第一层, 大概是10倍左右的Die Size。有两种方法制作: Emulsion Mask 和 Metal Mask。
��N_92,xI# Emulsion Mask:
;gL{*gR]�S  `%���\CO�`
`%���\CO�` 这货分辨率可以达到 2000line / mm (其实挺差劲的... 所以sub-micron ,也即um级别以下的 VLSI不用... )
,x\q�Yz+7| 制作方法: 首先: 需要在Rubylith上面刻出一个比想要的掩膜大个20倍的形状 (大概是真正制作
尺寸的200倍), 这个形状就可以用激光什么的刻出来, 只需要微米级别的刻度。然后:
{�>k�m�]CG 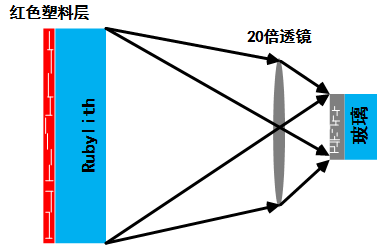 ��O1\4W�G%
��O1\4W�G% 给!它!照!相! , 相片就是Emulsion Mask! 如果要拍的"照片"太大, 也有分区域照的方法.
<oXBk�Ci0r Metal Mask:
��4M�%�|�N  8��pEA�3py
8��pEA�3py 制作过程:
;HC�K iHC� 1、先做一个Emulsion Mask, 然后用Emulsion Mask以及我之前提到的17-18步做Metal Mask! 瞬间有种Recursion的感觉有木有!!!
'`�;=d�<'� 2、Electron beam: 大概长这样
g(�zeOS]q} 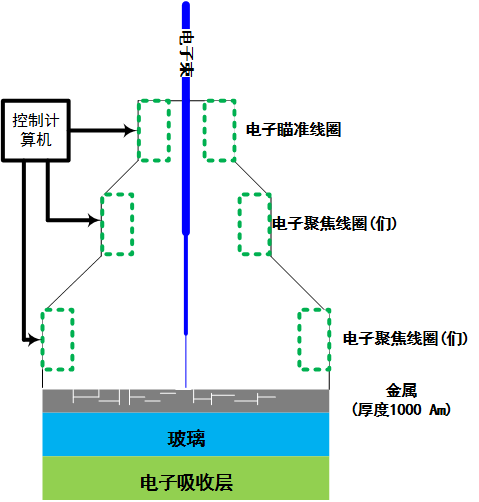 ^zTe9:hz/\
^zTe9:hz/\ 制作的时候移动的是底下那层. 电子束不移动. 就像打印机一样把底下打一遍.
r\QV%�09R 好处是精度特别高, 目前大多数高精度的(<100nm技术)都用这个掩膜. 坏处是太慢...
i�uj%�.�}
做好掩膜后:
�B�.=n U�� Feature Size = k*λ / NA
@|cH�DltH� k一般是0.4, 跟制作过程有关;λ是所用光的波长; NA是从芯片看上去, 放大镜的倍率. 以目前的
技术水平, 这个公式已经变了, 因为随着Feature Size减小, 透镜的厚度也是一个问题了:
2c]�751��� Feature Size = k * λ/ NA^2
H*G(�`�Zl} 恩.. 所以其实掩膜可以做的比芯片大一些. 至于具体制作方法, 一般是用高精度计算机探针 + 激光直接刻板. Photomask(掩膜) 的材料选择一般也比硅晶片更加灵活, 可以采用很容易被激光汽化的材料进行制作.
;��o'>`=�Y 这个光刻的方法绝壁是个黑科技一般的点! 直接把λ缩小了一个量级, 不附加成本! 你们说吼不吼啊!
>-V632(/{o Food for Thought: Wikipedia上面关于掩膜的版面给出了这样一幅图, 假设用这样的掩膜最后做出来会是什么形状呢?
yT:2*sZRc� 附图的步骤在每幅图的下面标注, 一共18步.
P��$z%:��Q 最终成型大概长这样:
Yt�c�[ k�p  dG+$��!*6Z
dG+$��!*6Z 其中, 步骤1-15 属于 前端处理 (FEOL), 也即如何做出场效应管
N( 7(~D=)B 步骤16-18 (加上许许多多的重复) 属于后端处理 (BEOL) , 后端处理主要是用来
布线. 最开始那个大芯片里面能看到的基本都是布线! 一般一个高度集中的芯片上几乎看不见底层的硅片, 都会被布线遮挡住.
u��hj]le�! 下面介绍一下SOI (Silicon-on-Insulator) 技术:
A3��.��I|/ 传统CMOS技术的缺陷在于: 衬底的厚度会影响片上的寄生电容, 间接导致芯片的性能下降. SOI技术主要是将 源极/漏极 和 硅片衬底分开, 以达到(部分)消除寄生电容的目的.
J�qz�w9��4 传统:
�4Y�'Ne2M{ 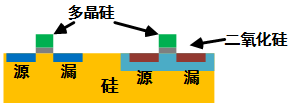 �`Stu��Ua�
�`Stu��Ua� SOI:
��y��=sae  �6|l�sG6uf
�6|l�sG6uf 制作方法主要有以下几种(主要在于制作硅-二氧化硅-硅的结构, 之后的步骤跟传统工艺基本一致.)1. 高温氧化退火:
�&_]G0~e��  8D�>5�(Dg-
8D�>5�(Dg- 在硅表面离子注入一层氧离子层
%AJ9f�s4/�  �` Ft-1�eE
�` Ft-1�eE 等氧离子渗入硅层, 形成富氧层
WI&A+1CK-5  ;ZuHv �{=
;ZuHv �{= 高温退火
WL�(Y1>�|j  h�<�M1q�1)
h�<�M1q�1) 成型.
,){#��J"W� 或者是2. Wafer Bonding(用两块! )不是要做夹心饼干一样的结构吗?
�T�*@�o?U�  #qk=R�7"�Q
#qk=R�7"�Q 来两块!
MA_YM�xP.' 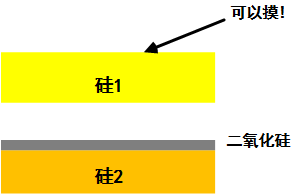 V�MF?qT3Nd
V�MF?qT3Nd 对硅2进行表面氧化
Q_p&~�PNy5  q.R(>Zc��V
q.R(>Zc��V 对硅2进行氢离子注入对硅2进行氢离子注入
#�|8%����h  �vn�*K\,��
�vn�*K\,�� 翻面
��;�o)'d�K  s)�E�8}-v
s)�E�8}-v 将氢离子层处理成气泡层将氢离子层处理成气泡层
YJ6:O�{AL1  ��Y5 �;�a�
��Y5 �;�a� 切割掉多余部分切割掉多余部分
q|%�+?j�(� 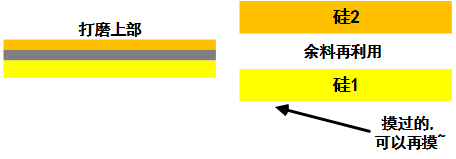 !YpH\wUyvP
!YpH\wUyvP 成型! + 再利用
$�,O8SW.O$  I@�z@s}x>�
I@�z@s}x>� 光刻
�vN
v'%;L  �EdqB4�-#7
�EdqB4�-#7 离子注入:
m+8:_�0x "  @�i> r(��X
@�i> r(��X 微观图长这样:
�F5+F�O^3E 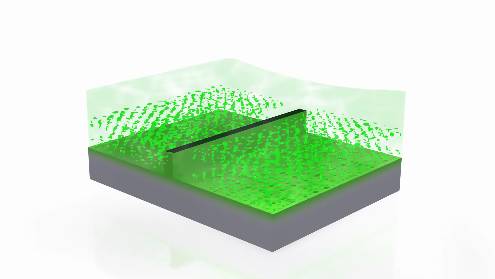 �.f�qy[qrM
�.f�qy[qrM 再次光刻+蚀刻
�8m�mnnf{P  &?Erk�c~�#
&?Erk�c~�# 撤去保护, 中间那个就是Fin撤去保护, 中间那个就是Fin
u�WCl�T):  %Iflf�]�l�
%Iflf�]�l� 门部位的多晶硅/高K介质生长门部位的多晶硅/高K介质生长
_vb'3~��'S 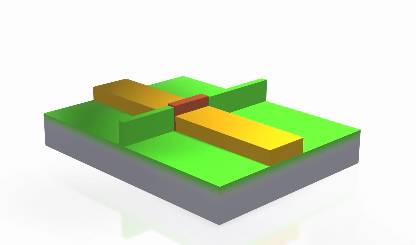 G�j�q7@F�'
G�j�q7@F�' 门部位的氧化层生长门部位的氧化层生长
%�^E�7Iqc  ���u�4T�$�
���u�4T�$� 长成这样
eD(5+b��m
 l]D���$QT3
l]D���$QT3 源极 漏极制作(光刻+ 离子注入)
��N�AtD�t= 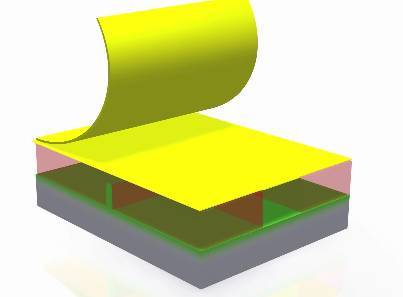 N LQ�".mM+
N LQ�".mM+ 初层金属/多晶硅贴片
�(Nz�`w��� 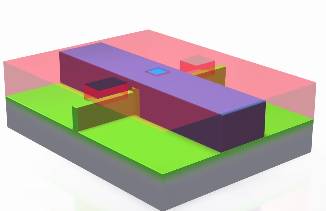 j�7�:r8? G
j�7�:r8? G 蚀刻+成型
9[�X'9*��,  5�5�ec23m�
5�5�ec23m� 物理气相积淀长出表面金属层(因为是三维结构, 所有连线要在上部连出)
6q�'Q�?Uw^ 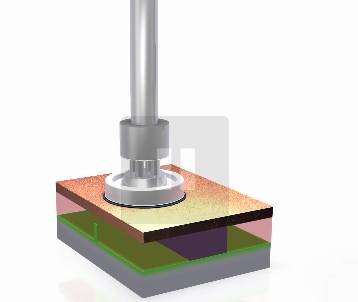 CV^%'HIs?+
CV^%'HIs?+ 机械打磨(对! 不打磨会导致金属层厚度不一致)
oV[��'%�Z' 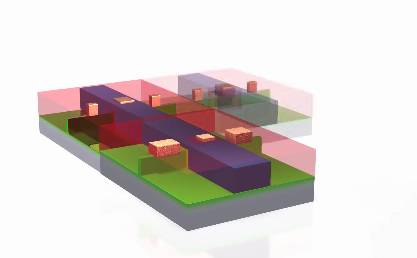 0+qC�_ISns
0+qC�_ISns 成型! 成型!
H�-�&27?s^  ;{H���Dz$
;{H���Dz$ 连线
&qP�ezyt�� 大概就是酱紫……
�3O4lG�e#u